2023年6月11-16日,超大规模集成电路国际研讨会(2023 Symposium on VLSI Technology and Circuits)在日本召开。太阳成集团集成电路学院在该会议上发表题为“Catching the Missing EM Consequence in Soft Breakdown Reliability in Advanced FinFETs: Impacts of Self-heating, On-State TDDB, and Layout Dependence”的研究论文。这是学院为第一单位首次在VLSI会议发表研究工作。
随着集成电路先进工艺节点不断微缩,对器件良率和可靠性的要求越来越苛刻。在以往的研究中,CMOS器件中栅介质层击穿(TDDB)和晶体管自热(self-heating)的耦合效应没有得到重视,两者之间的失效机制尚不明确。针对上述问题,吴幸教授团队与北京大学王润声教授团队以及上海交通大学纪志罡教授团队合作,基于16/14纳米先进工艺,通过尖端的原位表征技术,在原子尺度下揭示了FinFET器件自热和“开态TDDB”应力模式的耦合作用机理,首次发现了开态TDDB模式的软击穿(SBD)会引发中段(MOL)金属互连电迁移(EM)的现象,开展了该现象的物理建模,提出了相应的版图优化方案以抑制EM,为集成电路的可靠设计提供了依据。
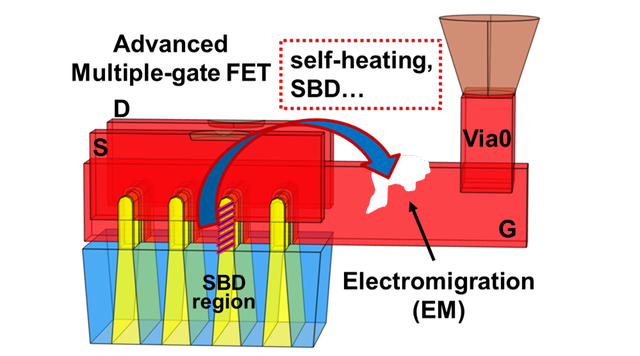
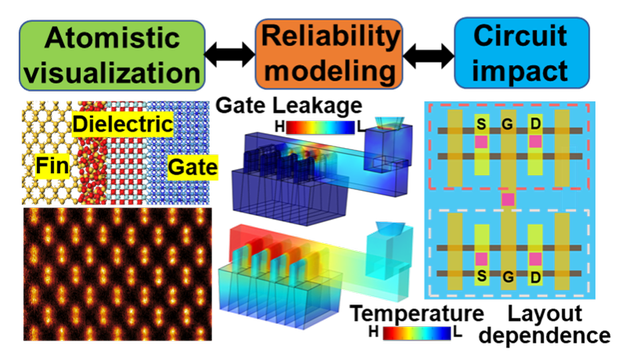
公司博士研究生董作院和北京大学集成电路学院博士研究生孙梓轩为论文共同第一作者。该工作得到了国自然重点项目的支持。

VLSI是世界学术界和企业界公认的集成电路领域的顶级会议,在国际半导体技术界享有很高的学术地位和广泛的影响力。2023年VLSI会议投稿难度大,Technology仅录用89篇。
相关链接:https://www.vlsisymposium.org

